 
The thinness of 2D channel materials makes establishing an electrical connection to a nanoribbon a daunting task, so Intel also modeled electrical contact topologies for 2D materials. Intel's paper describes a Gate All Around (GAA) stacked nanosheet structure with channel materials (nanosheets/nanoribbons) that measure a mere three atoms thick and can operate at room temperature with low leakage current. However, moving beyond RibbonFET will require further innovations, and this 2D research fits the bill of a potential pathway. Intel brands its GAA design as RibbonFET, which is currently planned to arrive in the first half of 2024. This is becoming more of an issue as transistors shrink - even when the gate surrounds the channel on three sides, as we see with FinFET transistors. 
This 'gate-all-around' (GAA) technique reduces voltage leakage that prevents switching off the transistors. 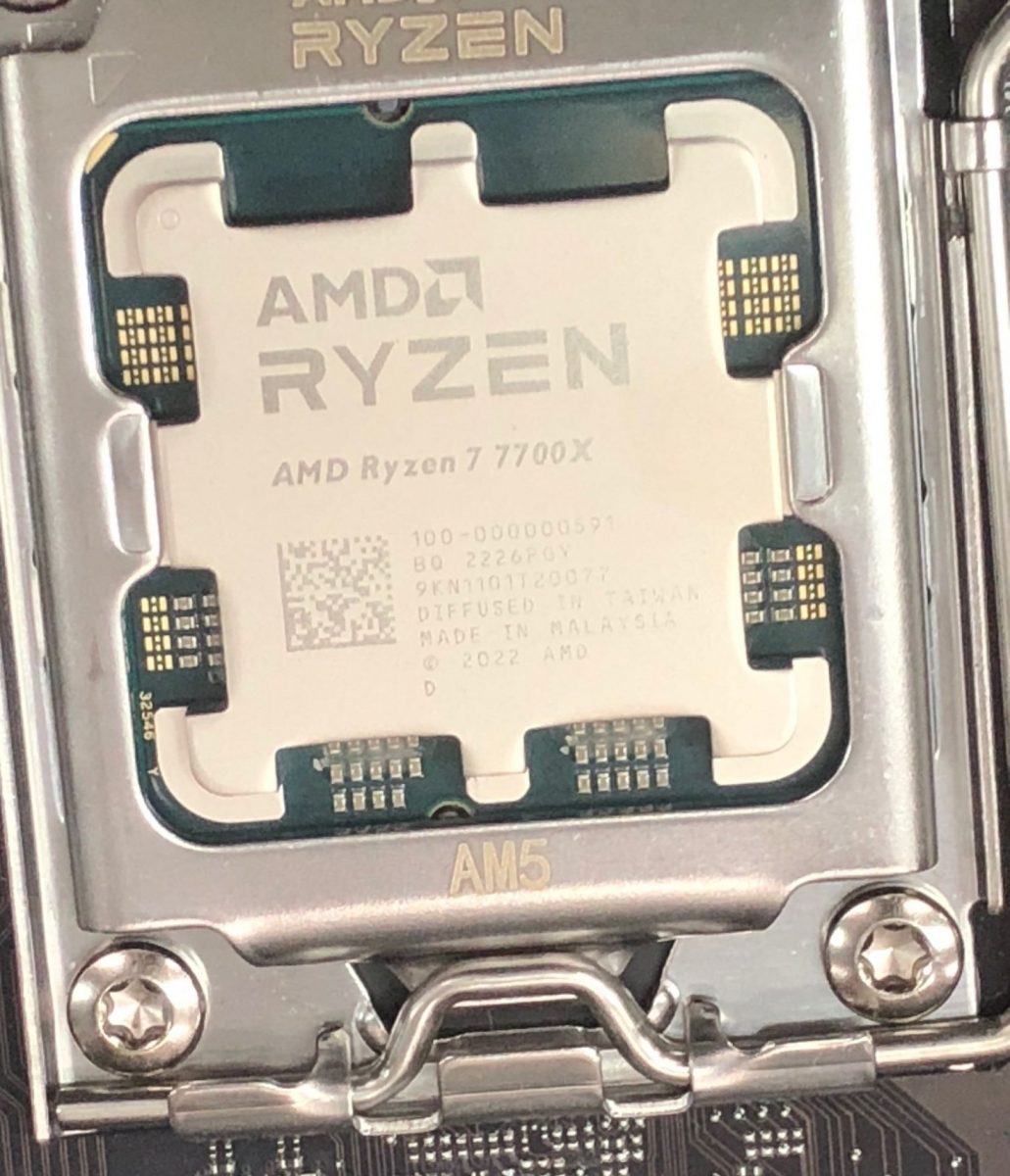
As a refresher, current GAA designs consist of stacked horizontal silicon nanosheets, with each nanosheet surrounded entirely by a gate. In contrast, 2D materials are attractive because all of the atoms are bonded in one plane, thus enabling features to be built with as small as three atoms of thickness.Įnter Intel's research into 2D materials that it could use for 3D GAA transistors. Today's chip materials, like silicon, are comprised of three-dimensional crystals, which means atoms are bonded in all three dimensions, thus presenting a fundamental limit to shrinking. Most of the industry is betting on a shift to 2D atomic channels in the future, but as with all new tech, there will be many steps to such a radical change. Intel's process roadmap already dips below the nanometer scale to the Angstrom scale, and even though the node naming conventions have long ago lost their relation to actual physical measurements of the transistors, it is clear that a radical new approach will be needed for continued scaling. In addition, the new paper outlines several new materials and processes that would be used to manufacture such devices, paving the way for real-world devices. This paper outlines incredible interconnect densities of hundreds of thousands of connections per square millimeter and power consumption (measured in picojoules per bit - Pj/b) that rivals what we see in monolithic processors. As such, Intel has found a pathway to a 100X improvement in just a few years, showing that the company's work in hybrid bonding is accelerating rapidly. QMC also enables multiple chiplets to be stacked vertically atop one another, as seen in the graphic above. That previous paper covered an approach with 10-micron pitches, which was already a 10X improvement. QMC is a new hybrid bonding technique that features sub-3 micron pitches and results in a 10X increase in power efficiency and performance density over the research Intel submitted at last year's IEDM. As the name implies, Intel's QMC aims to offer nearly the same characteristics as the interconnects that are built right into a single die. However, these approaches still result in inevitable performance, power, and cost tradeoffs, which Intel's new 'Quasi-Monolithic Chips' (QMC) 3D packaging tech looks to solve. The overriding goal of any chiplet-based design is to preserve the best attributes of the power consumption and performance (latency, bandwidth) of the data pathways inside of a single-die monolithic processor while tapping the economic benefits of using a chiplet-based approach, like increased yield from smaller dies fabbed on a leading-edge process and the ability to use older, cheaper nodes for some of the other functions that see lesser density improvements.Īs such, the battleground for semiconductor supremacy is shifting from the speed of the transistors to the performance of the interconnects, with new technologies like silicon interposers (EMIB) and hybrid bonding techniques coming to the forefront to improve economics.
0 Comments
Leave a Reply. |
AuthorWrite something about yourself. No need to be fancy, just an overview. ArchivesCategories |
 RSS Feed
RSS Feed
